TEM分野:千現地区 TEM Field:Sengen-site
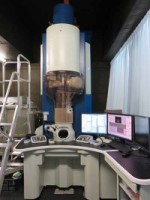
NM-502
実動環境対応電子線ホログラフィー
電子顕微鏡(JEM-ARM200F-B)
Real working environmental electron holography microscope
照射レンズ系、結像レンズ系のそれぞれにCEOS社製収差補正器CESCOR,CETCORを搭載し、空間分解能は0.08 nmに達します。冷陰極電子銃により低加速電圧でも高分解能STEM が可能です。バイプリズムも装着しており、ポテンシャル計測も可能です。OriusSC200(Gatan社),965 GIF Quantum ER(Gatan社)を装着しておりEELS,エネルギーフィルタ像の取得が可能です。

NM-518
マルチモーダル分析電子顕微鏡
Multimodal Analytical Electron Microscope
材料開発に必要な形態観察、元素分析、場の観察:TEM観察、回折図形取得、STEM(明視野、暗視野)、EDS測定、DPC測定、Tomography(TEM/STEM/EDS)

NM-503
200kV電界放出形透過電子顕微鏡
(JEM-2100F1)
200kV field emission transmission electron microscope
初心者にも使いやすい操作画面を備え、TEM、STEM、EELS、 EDS(点 /線分析、元素マッピング)、NBD、CBED など多機能、高分解能を有します。電子線回折図形が撮れるCCDカメラ(Gatan Orius200D) も装備しています。また、3 次元像観察用試料ホルダー及び再構成ソフトを備えています。

NM-504
200kV電界放出形透過電子顕微鏡
(JEM-2100F2)
200kV field emission transmission electron microscope
初心者にも使いやすい操作画面を備え、TEM、STEM、EELS、 EDS(点 /線分析、元素マッピング)、NBD、CBED など多機能、高分解能を有します。電子線回折図形が撮れるCCDカメラ(Gatan Orius200D) も装備しています。また、3 次元像観察用試料ホルダー及び再構成ソフトを備えています。

NM-505
200kV透過電子顕微鏡
(JEM-2100)
200kV transmission electron microscope
初心者にも使いやすい200kV透過電子顕微鏡です。LaB6電子銃を搭載し、TEMとEDS (点分析) が可能です。電子線回折図形が撮れるCCDカメラ(Gatan Orius200D) も装備しています。

NM-506
2軸傾斜バイアス印加・
加熱TEM試料ホルダー
(Lightning)
Double-tilt bias and heating TEM holder
Lightningホルダーを使い、各パラメータを完全制御することで、再現性のある実験結果を得ることで、材料の特性評価が可能になります。

NM-507
2軸傾斜液体窒素冷却TEM試料ホルダー
(Gatan 636)
Double-tilt LN2 cryo TEM holder
TEM冷却ホルダーは、試料を液体窒素又は液体ヘリウムを使って冷却して低温観察を行います。また、カーボンコンタミネーションを軽減する目的にも有効です。
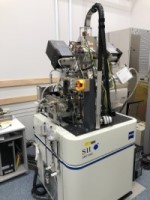
NM-302
微細組織三次元マルチスケール解析装置
(SMF-1000)
Orthogonal FIB-SEM
FIB-SEM-Ar-ionのトリプルガンを装備した電子顕微鏡です。高い空間分解能・コントラストでのシリアルセクショニングによる3D再構築像観察を可能にするため、FIBとSEMとを直交に配置した装置です。EBSD、EDS、STEM(BF、ADF)などの多彩な検出器による同時測定が可能です。
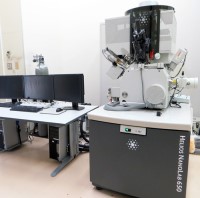
NM-517
FIB/SEM精密微細加工装置(Helios 650)
FIB/SEM microfabrication instrument
1. 集束イオンビーム(FIB)加工
2. 走査型電子顕微鏡(SEM)観察
3. TEM試料作製

NM-509
デュアルビーム加工観察装置(NB5000)
Dual Beam system
集束イオンビーム(FIB) 加工と走査型電子顕微鏡観察(SEM) が可能な装置です。SEMで観察しながらFIB加工が可能です。他機能として、EDSやSTEM、Mill&Monitorが可能です。またカラム内で加工薄片をマイクロサンプリングすることが出来ます。

NM-510
FIB加工装置(JIB-4000)
Focused Ion Beam system
FIB(集束イオンビーム)でバルク試料からTEM薄膜試料片を直接製作する装置です。サブミクロン精度で興味のある場所のTEM試料作製が出来ます。FIB内で加工・分離をした試料片をピックアップシステムによりメッシュ上へ接着することも可能です。
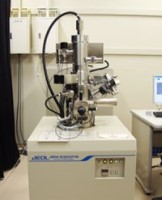
NM-511
FIB加工装置(JEM-9320FIB)
Focused Ion Beam system
FIB(集束イオンビーム)でバルク試料からTEM薄膜試料片を直接製作する装置です。サブミクロン精度で興味のある場所のTEM試料作製が出来ます。FIB内で加工・分離をした試料片をピックアップシステムによりメッシュ上へ接着することも可能です。
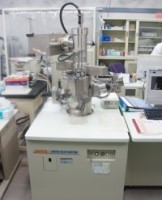
NM-512
FIB加工装置(JEM-9310FIB)
Focused Ion Beam system
FIB(集束イオンビーム)でバルク試料からTEM薄膜試料片を直接製作する装置です。サブミクロン精度で興味のある場所のTEM試料作製が出来ます。FIB内で加工・分離をした試料片をピックアップシステムによりメッシュ上へ接着することも可能です。
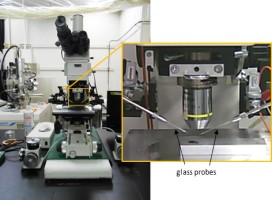
NM-513
ピックアップシステム
Pick-up System
FIBで加工・分離した試料片を、大気中(FIB外)でガラスプローブを使ってメッシュ上へ固定するための設備です。

NM-514
ウルトラミクロトーム(Leica EM UC6)
Ultramicrotome
生物試料や高分子試料などのソフトマテリアルについて、ガラスナイフまたはダイヤモンドナイフを使用して薄切切片を製作する装置です。試料を冷却しながら切り出すことも可能です。

NM-515
電子線トモグラフィー解析システム
Electron tomography analysis system
3次元画像データ解析ツールです。ソフトウエアの一部はライセンス条項の制約上、ユーザー自身で利用できないものがあります。

NM-516
TEM試料作製装置群
TEM sample preparation apparatus
切断、機械研磨、イオン研磨、化学機械研磨(CMP)、包埋、染色処理等。貼り合わせ断面試料、平面試料、ダメージレスくさび形試料、低温低加速イオン研磨試料、生体材料試料、高分子材料試料など、ご要望に応じた試料作製が可能です。




