Surface Analysis

- PHI TRIFT V nanoTOF
Time-of-Flight Secondary Ion Mass Spectrometry TOF-SIMS is a mass spectrometry technique to analyze secondary ions emitted from a sample surface irradiated with a pulsed ion beam of less than 1012 ions/cm2 by using a time-of-flight mass analyzer. A high-resolution mass spectrum acquisition, 2D imaging, depth profiling and 3D imaging are available for both inorganic and organic materials such as semiconductors and polymers. Our professional staff assists with measurements and data interpretation.(Room 123, Physical Analysis Laboratories at Sengen)
-
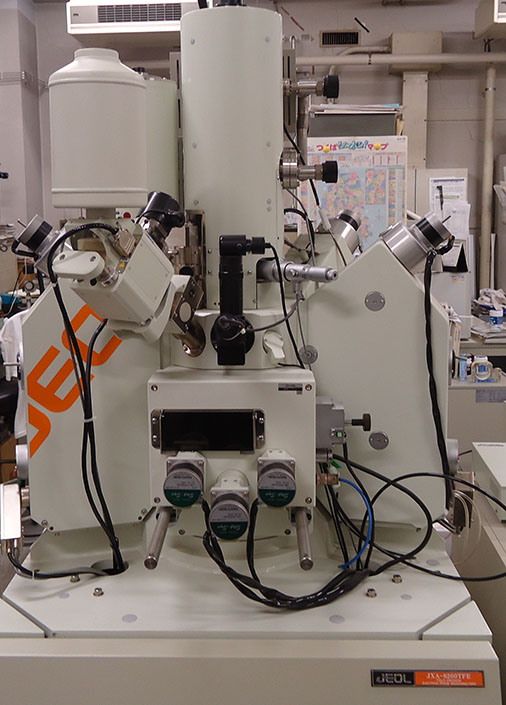
- Field Emission Electron Probe Micro-Analyzer (JXA-8500F) FE- EPMA is equipped with FE type electron gun to obtain high sensitivity and small area analysis such as 0.1μm order. The compositional analysis and elemental mappings are available on the surface of metals, semiconductors etc.
-
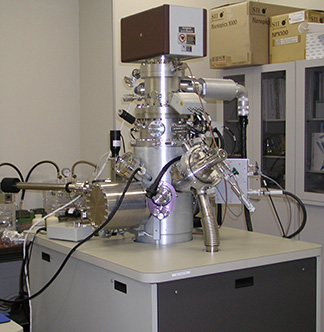
- Scanning Auger electron Microprobe (PHI680) Auger electron spectroscopy (AES) is an analysis method of chemical composition and chemical state by measuring the energy distribution of Auger electrons emitted from the sample surface by electron beam irradiation. The chemical composition in small area, elemental Mapping and depth profiling with Ar ion beam sputter etching are available. This instrument comprises sample fracture device in the ultra high vacuum.
-
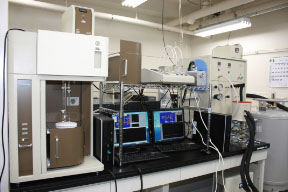
- Surface area and pore size analyzer (BELSORP-max/BELSORP-HP) Evaluation of specific surface area and average particle size for nanoparticles/microparticles, nanofiber and nanotubes. Characterization of pore size distribution of porous materials including mesopore (diameter < 200 nm) and micropore (diameter < 2 nm) range. Measurement of vapor adsorption (water, alcohols and volatile organic liquids). High-pressure adsorption measurement using nitrogen and other gases.




