A28:FIB-SEMNanoGREEN棟 E-108室

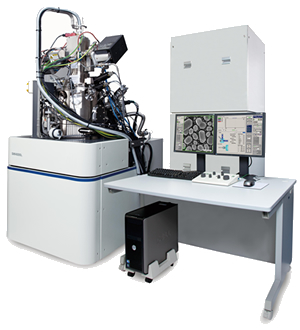
|
メーカー名 |
Hitachi High-Tech Science |
|---|---|
|
型式 |
SMF2000 |
|
用途 |
FIB加工およびSEM/STEM観察 |
|
概要 |
FIBとSEMの鏡筒が直角配置され,FIB加工と観察を繰り返すことにより3D再構築が可能。クライオホルダーを用いることにより低ダメージでの加工/観察が可能。EDS測定、STEM観察が可能。大気非曝露搬送対応。 |
装置仕様
FIB(集束イオンビーム)
|
イオン源 |
Ga 液体金属イオン源 |
|---|---|
|
加速電圧 |
1,2,3kV及び5~30kV(5kVステップ) |
|
観察視野 |
0.5μmx0.5μm~φ2mm |
|
像分解能 |
4.0nm(30kV) |
|
最大ビーム電流 |
90nA |
SEM(電子ビーム)
|
電子銃 |
熱電界放出型電子銃(ZrO/W) |
|---|---|
|
加速電圧 |
0.1~30kV(10kVステップで設定可能) |
|
観察視野 |
0.125μmx0.125μm~2mmx2mm(10kV) |
|
像分解能 |
1.1nm(20kV),1.5nm(10kV),2.5nm(1kV) |
|
STEM分解能 |
0.8nm(30kV) |
|
最大ビーム電流 |
10nA |
|
検出器 |
STEM検出器,BSE検出器 |
低加速Arイオンビーム
|
イオン源 |
PIG型ガスイオン源 |
|---|---|
|
加速電圧 |
0.5~1kV |
|
最大ビーム電流 |
10nA |
その他
|
分析器 |
エネルギー分散型X線分析装置(EDS) |
|---|---|
|
試料ホルダー |
クライオ雰囲気遮断(一軸) |
|
試料搬送 |
大気非曝露搬送対応 |
使用上の注意
- 超高真空機器につき,揮発成分により装置内を汚染する可能性のある試料は原則測定できません。揮発成分のある試料につきましては事前にご相談下さい。(硫化物を含む試料は測定不可)
