 |
国際連携 I (姉妹機関との共同研究) |
|
NIMS-マックスプランク金属研究所 |
||||||
|
|
||||||
|
||||||

|
||||||||||
|

|
|||||||||
| 現在の高度情報化社会を支えているのは集積回路です。これを支えているのが電極材料/ゲート酸化膜/Si構造を持つ電界効果を使ったトランジスタで、通常MOSFET(Metal Oxide Semiconductor Field Effect Transistor)と呼ばれています。高集積化、高速化がすすむ現在の集積回路では、近い将来45nmゲート幅のMOSFETが作製されると予想されています。その際にはゲート酸化膜としてHfO2を含む高誘電非晶質酸化物材料(HfSiOxなど)、いわゆるHigh-K材料が使われ、ゲートには金属材料が用いられるとされています(図1参照)。この場合、金属ゲートとゲート酸化膜との界面が重要になります。MOSFETのOn-Offを制御するための電圧の最小値はしきい値電圧(Vth)といわれますが、その値はSi中の電気伝導性を制御する不純物濃度、ゲート酸化膜の誘電率、ゲート材料の仕事関数で細かく制御する必要があります。ところが、HfSiOxなどのHigh-K材料を用いた場合、このしきい値電圧Vthが予想値から大きくずれるという問題がありました。HfSiOxなどの酸化物材料はゲート材料との反応によって膜中に原子空孔が発生し、2つの自由電子とプラスの電荷を持つ未結合手をつくります。この自由電子は酸化物の外に出て金属側に入り、界面に電気二重層を作ります。これがしきい値電圧のずれの原因とされています。この問題を解決するためには金属ゲートとゲート酸化膜中に空孔を発生させないことが重要です。マックスプランク金属研究所はこれまで酸化物と金属の界面反応に関する研究を精力的に進めてきた研究機関です。ここではNIMSのコンビナトリアル手法を使って作製した試料を使いHfO2系酸化物とタングステンなど各種金属との反応を透過型電子顕微鏡を用いて評価しました。その結果、タングステンはHfO2系酸化物(HfSiOx)とほとんど反応せず急峻な界面を形成することがわかりました(図2参照)。これは熱力学の観点からも正しいことが証明され、次世代金属ゲート材料候補の1つをみつけることができました。今後は仕事関数制御を行った金属合金と他のHfO2系酸化物の反応性に関して研究をさらに進めていきます。 |
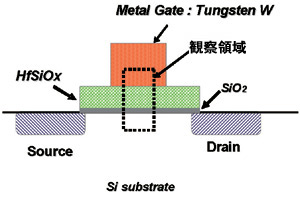 図1 次世代MOSFET構造の概念図. |
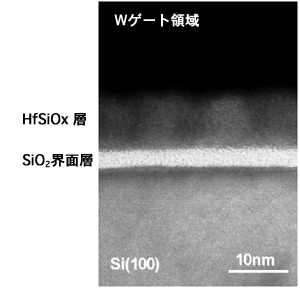
|
|||
|
|
|