 |
ナノ構造形成・ナノ計測・ナノ機能制御の最前線 |
導電性ナノワイヤの電気抵抗の直接計測
-2探針走査トンネル顕微鏡による測定-

| ナノマテリアル研究所 ナノ電気計測グループ | ||
|
久保 理 |
新ヶ谷 義隆 |
中山 知信 |
導電性ナノワイヤの電気抵抗の直接計測 -2探針走査トンネル顕微鏡による測定- |
 |
|||||
|
|
||||||
|
||||||
| シリコンテクノロジーを基礎とした半導体デバイスの高集積化・高性能化は、近い将来物理的限界に達すると予測されています。今、分子デバイスや量子デバイスなどの新機能ナノデバイスや、そこで利用するナノスケール構造の機能を、直接計測・評価し、次世代のナノエレクトロニクスを具体化していくことが私達の急務です。 私達が開発した2探針走査トンネル顕微鏡(DP-STM)は、原子レベルで先鋭化された二本の金属探針をテスタの電極のように利用しうる、新しい計測装置です。個々の探針は走査トンネル顕微鏡(STM)としての機能を有しているので、テスタ電極の位置を原子精度で制御できる電気特性計測装置-ナノテスタ-として機能します。 今回、DP-STMによって、シリコン(Si)表面上の導電性ナノワイヤの電気抵抗を測定しました。清浄なSi(001)表面上にエルビウム(Er)原子を供給すると、ErSi2単結晶が得られます。六方晶であるErSi2結晶(図1)のc軸方向とSi結晶との間の格子間隔のずれがa軸方向に比べて大きいため、適切な温度条件下では自発的にナノワイヤ状のErSi2単結晶が得られ、その断面は3~10nm(幅)×1nm(高さ)、長さは最長で約1μmでした。 電気抵抗測定では、まず、表面上のErSi2ナノワイヤをSTM観察し、一本のナノワイヤを選びます。選択したナノワイヤの両端に二本の探針を接触させ(図2)、探針間の電圧と電流との間にオームの法則が成り立つことを確認した上で、探針間の抵抗値Rを測定しました。探針間の距離Lを狭めつつRを逐次測定した結果、Lの減少に対してRが直線的に減少し(図3)、その傾きから、ナノワイヤの抵抗率が求まりました。測定したErSi2ナノワイヤの抵抗率は、バルクのErSi2の抵抗率に比べて1桁程度大きく、ナノスケール導体における表面散乱の効果を示したものとなりました。 DP-STMによって初めて可能になった今回の計測は、装置の有用性を如実に示しています。今後、ナノエレクトロニクスの具体化に向けた材料開発や素子開発において、DP-STMに代表される多探針走査プローブ顕微鏡装置の重要性はますます高まると考えています。 |
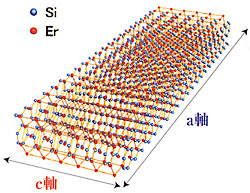
|
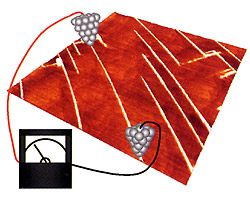
|
|
図1 ErSi2ナノワイヤの構造モデル |
図2 Si(001)表面上のErSi2ナノワイヤのSTM像 |
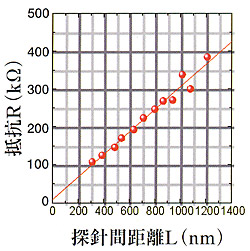
|
|
図3 ナノワイヤの電気抵抗と探針間距離との関係 |