 環境問題解決に挑む物質材料研究
環境問題解決に挑む物質材料研究
鉛フリーはんだ実装を支える信頼性解析技術
― 高信頼度の低環境負荷微細接合を目指して ―

|
エコマテリアル研究センター |
|
苅谷 義治 |
 環境問題解決に挑む物質材料研究 環境問題解決に挑む物質材料研究
鉛フリーはんだ実装を支える信頼性解析技術 ― 高信頼度の低環境負荷微細接合を目指して ― |

|
|
|
|
||
|
| 廃電気・電子機器(WEEE)および有害物質の使用規制(RoHS)指令案が、ついに欧州議会で可決され、2006年より施行されることが決定しました。これに伴い、鉛フリーはんだの本格的な実用化が進められています。 鉛フリーはんだ実装においては、単に鉛を含まないということだけではなく、はんだ接合部の疲労などの力学的な信頼性が重要となります。特にLSIパッケージ用の微細接合においては、Siチップと有機基板の熱膨張係数差(それぞれ2.6ppm/K,および18ppm/K)から、チップ動作に伴うジュール熱や、外的な温度変化により図1に示すようにはんだ接合部に非弾性ひずみが繰り返し生じ、最終的には、図2に示すようにはんだ接合部が疲労損傷します。電子基板には膨大な数の接合部が存在しますが、そのうち一箇所でも疲労破壊すれば、その製品は機能しなくなります。これが輸送機器の制御や安全装置に用いられている場合、深刻な事故へ繋がりかねません。 現在、比較的信頼性に優れるSn‐Ag‐Cu系合金を中心として実用化が進められていますが、微細化の一途を辿る電子実装部においては、より疲労耐久性に優れる鉛フリーはんだ合金が求められます。このような高い信頼性が要求される実装部の開発には、極めて微小な接合部の力学的信頼性を正確に評価できる試験および解析技術が必要不可欠となります。 私達は、微細LSI実装部に繰り返しひずみを負荷できるマイクロ疲労試験機、および計算機を利用した高精度な応力および非弾性ひずみ解析技術を開発し、より疲労耐久性に優れるSn‐Ag‐Cu系鉛フリーはんだ合金開発を支援してきました。現在は、これらの解析技術を利用して、より高信頼度な鉛フリーはんだ材料の開発のみならず、導電性樹脂接着材など、はんだ合金以外の材料を用いてより低環境負荷で、より微細な実装技術の開発に取り組んでいます。 |
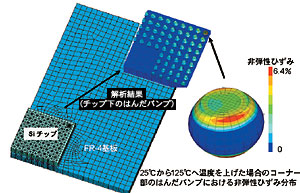
|

|
| 図1 有限要素法解析によるフリップチップはんだバンプの熱疲労中における非弾性ひずみ分布の例(1/4 対照モデル、弾塑性クリープ解析).コーナーに位置するはんだバンプにおいて大きな非弾性ひずみが発生していることがわかる. | 図2 はんだバンプにおける疲労き裂進展の様子.有限要素法解析結果のひずみ集中箇所に対応して疲労き裂が観察される(100 サイクル経過後). |